增强高分辨率图案的材料以推进微电子技术的发展
为了提高处理速度并降低电子设备的功耗,微电子工业继续推动越来越小的特征尺寸。今天的手机中的晶体管通常为10纳米(nm) - 相当于大约50个硅原子宽或更小。将晶体管缩小到这些尺寸以下以更高的精度需要用于光刻的先进材料 - 用于在硅晶片上印刷电路元件以制造电子芯片的主要技术。一个挑战是开发稳健的“抗蚀剂”或用作模板的材料,用于将电路图案转移到诸如硅的器件有用的衬底中。
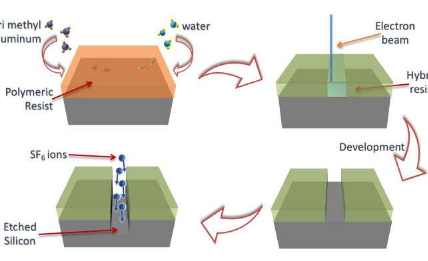
现在,来自功能纳米材料中心(CFN) - 美国能源部(DOE)布鲁克海文国家实验室科学用户设施的科学家们已经使用最近开发的渗透合成技术来制造结合有机聚合物聚合物的抗蚀剂(甲基丙烯酸甲酯)或PMMA,与无机氧化铝。PMMA因其低成本和高分辨率而成为电子束光刻(EBL)中使用最广泛的抗蚀剂,这是一种利用电子来制作图案模板的光刻技术。然而,在产生超小特征尺寸所需的抗蚀剂厚度下,当图案被蚀刻到硅中时,图案通常开始劣化,不能产生所需的高纵横比(高宽比)。
正如7月8日在线发表在材料化学杂志C上的论文中所报道的那样,这些“混合”有机 - 无机抗蚀剂表现出高的光刻对比度,并且能够图案化具有高纵横比的高分辨率硅纳米结构。通过改变渗透到PMMA中的氧化铝(或不同的无机元素)的量,科学家可以针对特定应用调整这些参数。例如,诸如闪存驱动器的下一代存储器设备将基于三维堆叠结构以增加存储密度,因此需要极高的纵横比; 另一方面,非常高的分辨率是未来处理器芯片最重要的特性。
“我们使用现有的抗蚀剂,廉价的金属氧化物和几乎所有纳米加工设备中常见的设备,而不是采用全新的合成路线,”CFN电子纳米材料集团的博士后研究员,第一作者Nikhil Tiwale说。
虽然已经提出了其他混合抗蚀剂,但是它们中的大多数需要高电子剂量(强度),涉及复杂的化学合成方法,或者具有昂贵的专有组合物。因此,这些抗蚀剂对于下一代电子设备的高速率,大批量制造而言不是最佳的。
传统上,微电子工业依赖于光学光刻,其分辨率受到抗蚀剂暴露于的光的波长的限制。然而,EBL和其他纳米光刻技术如极紫外光刻(EUVL)可以推动这一限制,因为电子和高能紫外光的波长非常小。这两种技术的主要区别在于曝光过程。
“在EBL中,你需要写出你需要逐行曝光的所有区域,有点像用铅笔做草图,”Tiwale说。“相比之下,在EUVL中,您可以一次性曝光整个区域,类似于拍照。从这个角度来看,EBL非常适合研究目的,EUVL更适合大批量生产。我们相信我们为EBL演示的方法可以直接应用于EUVL,其中包括三星在内的公司最近开始使用它们开发7纳米技术节点的制造工艺。“
在这项研究中,科学家使用原子层沉积(ALD)系统 - 一种标准的纳米加工设备,用于在表面上沉积超薄膜 - 以结合PMMA和氧化铝。在将涂有PMMA薄膜的基材放入ALD反应室后,它们引入铝前体蒸气,其通过PMMA基质内的微小分子孔扩散,与聚合物链内的化学物质结合。然后,他们引入另一种前体(例如水),其与第一前体反应以在PMMA基质内形成氧化铝。这些步骤一起构成一个处理周期。
然后,该团队使用具有多达八个处理周期的混合抗蚀剂执行EBL。为了表征不同电子剂量下抗蚀剂的对比度,科学家测量了暴露区域内抗蚀剂厚度的变化。使用原子力显微镜(具有原子级尖锐的显微镜用于跟踪表面的形貌)和通过椭圆偏振法获得的光学测量产生的表面高度图(基于从反射光反射的光的偏振变化确定膜厚度的技术)。表面)显示厚度随着加工周期的数量逐渐变化,但随着额外的循环迅速变化 - 即氧化铝含量较高。
在两个处理循环之后,混合抗蚀剂的蚀刻选择性超过ZEP的蚀刻选择性,ZEP是昂贵的抗蚀剂。在四个循环之后,混合抗蚀剂的蚀刻选择性比二氧化硅(SiO 2)高40%。图片来源:布鲁克海文国家实验室
“对比度是指抗蚀剂在暴露于电子束后变化的速度,”CFN电子纳米材料集团的材料科学家Chang-Yong Nam解释说,他负责监督该项目并与Jiyoung Kim合作构思了这个想法。德克萨斯大学达拉斯分校材料科学与工程系教授。“暴露区域高度的突然变化表明,对于更高数量的渗透循环,抗蚀剂对比度增加 - 几乎是原始PMMA抗蚀剂的六倍。”
科学家们还利用混合抗蚀剂对硅衬底中的周期性直线和“弯头”(交叉线)进行图案化,并比较了抗蚀剂与基板的蚀刻速率。
“你希望硅的蚀刻速度比抗蚀剂快;否则抗蚀剂会开始降解,”Nam说。“我们发现我们的混合抗蚀剂的蚀刻选择性高于昂贵的专有抗蚀剂(例如ZEP)和使用中间”硬“掩模层(如二氧化硅)以防止图案降解的技术,但需要额外的处理步骤“。
展望未来,该团队将研究混合抗性如何应对EUV暴露。他们已经开始在Brookhaven的国家同步加速器光源II(NSLS-II)上使用软X射线(能量范围对应于EUV光的波长),并希望使用由X射线光学中心操作的专用EUV光束线。劳伦斯伯克利国家实验室的高级光源(ALS)与行业合作伙伴合作。
“EUVL抵抗层的有机层对能量的吸收非常微弱,”Nam说。“添加无机元素,如锡或锆,可以使它们对EUV光更敏感。我们期待探索我们的方法如何解决EUVL的抗蚀剂性能要求。”
